碳化硅外延缺陷分类及其产生原因分析
三角形缺陷是4H-SiC(碳化硅)外延生长中的一种特殊形貌缺陷,具有以下特点:1.形貌特征:三角形缺陷起始于外延层/衬底界面处,在基晶面内延伸到外延层表面。U-GSB和D-GSB之间的距离随外延层厚度增加而增大,可用d/tan(4º)表示,其中d是外延层厚度,4º是衬底偏角。小坑缺陷的本质是衬底TSD位错贯穿到外延层的顶端,因此外延层小坑缺陷的密度和分布与衬底TSD位错的密度和分布相近。这意味着,
碳化硅(SiC)是一种重要的半导体材料,具有高耐热性、高硬度、高热导率、高电子迁移率和优异的化学稳定性等特点,广泛应用于高温、高频、高功率电子器件中。然而,在碳化硅外延生长过程中,常常会产生各种缺陷,这些缺陷会影响材料的电子性能和器件的可靠性。以下是一些常见的碳化硅外延缺陷:
掉落颗粒物( downfall defect)
在4H-SiC(碳化硅)外延生长中,掉落颗粒物缺陷是一种常见的外延缺陷,具有以下特点:
1. 形貌特征:
大型点状形貌:这种形貌的缺陷呈现为较大的点状结构,可能在外延层表面形成大小不一、形状各异的凹陷或凸起。
以颗粒物为头的三角形形貌:这种形貌的缺陷以一个颗粒物为顶点,形成一个三角形的凹陷结构,通常可以通过强光束或显微镜直接观察到。

4H-SiC 外延层表面上的掉落颗粒物的显微图像
2. 产生原因:
产生原因主要是在4H-SiC外延生长前或生长过程中,反应生长室内壁上的黑色无定形碳、SiC小颗粒物或其他尘埃颗粒物掉落在衬底或外延层表面上。这些掉落的颗粒物在外延生长结束后,可能局部或全部地陷入外延层中,形成外延形貌缺陷。
三角形缺陷(triangular defect)
三角形缺陷是4H-SiC(碳化硅)外延生长中的一种特殊形貌缺陷,具有以下特点:1.形貌特征:三角形缺陷起始于外延层/衬底界面处,在基晶面内延伸到外延层表面。这种缺陷沿台阶流动方向形成,并且其高度满足关系式 L = d/sin(4º),其中d为4H-SiC外延层厚度。三角形缺陷的本质是由变形的4H-SiC晶型边界和含有3C晶型夹层的三角形区域构成,在{0001}晶面上形成3C-SiC区域,因此在紫外光下的荧光显微镜图像中呈现三角形状或图案。
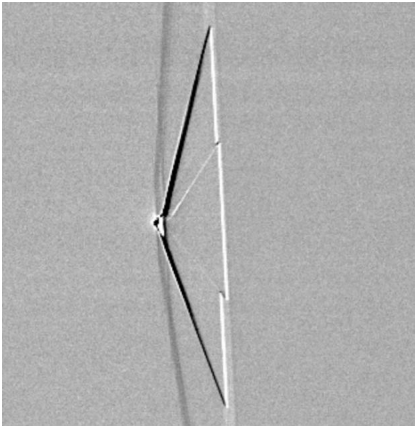
TSD 位错引起的三角形缺陷图像
2. 产生原因:三角形缺陷的形成通常与外来颗粒物、表面划痕或诸如TSD(三角形晶体形貌缺陷)等晶体结晶缺陷有关。这些因素影响了原子台阶流动,导致在4H-SiC外延层表面上形成具有三角形形状或图案的表面形貌缺陷。例如,掉落的颗粒物、TSD位错和划痕都可以引起三角形缺陷的出现。
彗星缺陷(comet)
彗星缺陷是4H-SiC(碳化硅)外延生长中的一种特殊形貌缺陷,具有以下特点:
1.形貌特征:彗星缺陷在4H-SiC外延层表面表现出彗星状的外形,通常它具有独立的“脑袋”和“尾巴”。这些缺陷平行排列,与主参考边[11-20]方向平行,长度相近,基本满足L=d/sin4º关系,其中d为4H-SiC外延层厚度。

彗星缺陷的光学图像
2. 产生原因:彗星缺陷的形成原因与三角形缺陷类似,通常起始于掉落颗粒物、位错或微管。在化学计量偏向富硅的外延工艺条件下,容易形成彗星缺陷。这意味着,在一定的生长环境下,由于杂质或缺陷的存在,会影响原子层的有序排列,从而形成具有特定方向和形状的彗星状缺陷。
胡萝卜缺陷 (carrot)
胡萝卜缺陷是4H-SiC(碳化硅)外延生长中的一种特殊形貌缺陷,具有以下特点:
1.形貌特征:胡萝卜缺陷在4H-SiC外延层表面呈现出胡萝卜状的形貌。这种缺陷起始于外延层/衬底界面处,随着外延层厚度的增大,沿[11-20]方向延伸,且与主平边[11-20]方向平行。长度基本相同,满足关系式L=d/sin(θ),其中d为4H-SiC外延层厚度,θ为衬底表面的偏转角度(θ=4º)。

TSD 位错引起的胡萝卜缺陷
2. 组成:胡萝卜缺陷由三个缺陷组成,即基平面层错、棱柱面层错和两者交界处的阶梯杆状位错。基晶面层错是插入一个双原子层的Frank型层错,层错的一个边界为Frank型不全位错,层错堆垛序列为(2232)。而棱柱面层错与3C-SiC包裹体相同,与外延层表面相交形成胡萝卜形形貌。
3. 产生原因:胡萝卜缺陷通常起因于衬底中的TSD位错。衬底表面上的划痕也会产生胡萝卜缺陷。这意味着,缺陷的形成与衬底的质量和处理过程密切相关。
小坑缺陷(pit)
小坑缺陷是4H-SiC(碳化硅)外延生长中的一种常见的形貌缺陷,具有以下特点:
1.形貌特征:小坑缺陷在4H-SiC外延层表面呈现出小凹陷或小坑状的外形。这些小坑的深度大约在20 nm左右,沿<11-20>方向的尺度一般小于5微米。小坑缺陷的本质是衬底TSD位错贯穿到外延层的顶端,因此外延层小坑缺陷的密度和分布与衬底TSD位错的密度和分布相近。
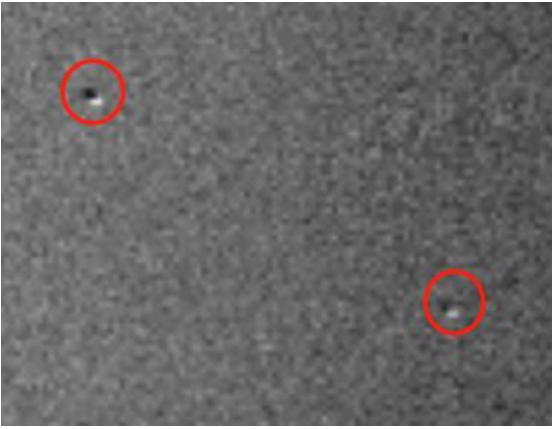
小坑缺陷
2. 产生原因:小坑缺陷主要是由衬底TSD位错贯穿到外延层所产生的。这意味着,小坑缺陷的形成与衬底中TSD位错的存在密切相关。在外延生长过程中,这些位错会向上延伸,最终在外延层表面形成小坑状的缺陷。
梯形缺陷 (Trapezoid Defect)
1.形貌特征:梯形缺陷在4H-SiC外延层表面表现为平行于<1-100>方向、两条长度不等的上游短坡堤线(U-GSB)和下游长巨观台阶线(D-GSB)构成的梯形表面形貌缺陷。U-GSB和D-GSB之间的距离随外延层厚度增加而增大,可用d/tan(4º)表示,其中d是外延层厚度,4º是衬底偏角。
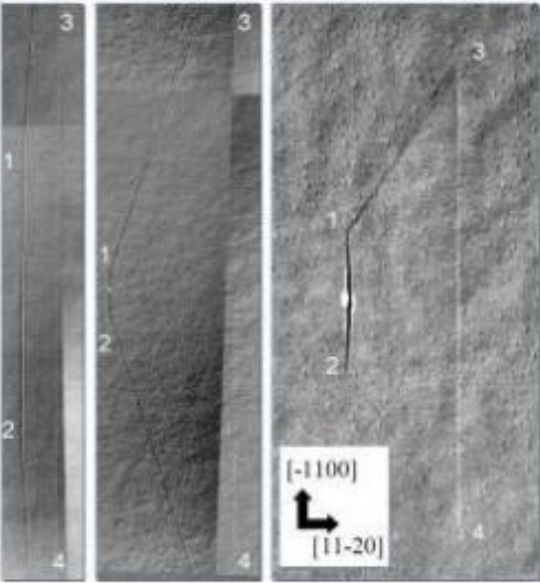
梯形缺陷
2. 产生原因:梯形缺陷起始于BPD、TED和TSD等位错及划痕周围的位错环,而生长过程则是由于团簇效应所致。
这些缺陷的形成和发展对4H-SiC材料的质量和性能具有重要影响,因此在生长过程中需要采取措施减少这些缺陷的产生。
台阶聚集 (Step Bunching)
台阶聚集 (Step Bunching) 是4H-SiC(碳化硅)外延生长中的一种特殊表面形貌特征,具有以下特点:
1.形貌特征:台阶聚集在4H-SiC外延层表面表现为平行于<1-100>方向的多个原子台阶汇聚在一起而形成的平行线簇。这种聚集是外延层表面出现的一种形貌特征,自身不存在结晶缺陷,因此在光致发光(PL)图像中一般不会出现形状或图案。

隐含划痕引起的台阶聚集区
2. 产生原因:台阶聚集的形成主要由衬底结晶缺陷、衬底表面划痕及隐含划痕引起,通常产生于氢气(H2)刻蚀过程。这些因素影响了原子台阶的流动和排列,导致台阶聚集的形成。台阶聚集对于外延层的表面平整度和光学性质有一定影响,因此在生长和后续处理过程中需要注意控制这种现象。
外延凸起 (Epi-Crown)
外延凸起 (Epi-Crown) 是4H-SiC(碳化硅)外延生长中的一种边缘形貌缺陷,具有以下特点:
1.形貌特征:外延凸起是指外延晶片边缘高度凸起造成的形貌缺陷,表现为晶片边缘区域的高度相对于晶片中心区域有明显的凸起。

外延凸起缺陷
2. 产生原因:外延凸起的形成主要有两个原因:
- 晶片上游端边缘区域由于缺乏原子台阶的补充,导致外延层表面高度与晶片边缘的高度出现差异。
- 晶片边缘应力引起的三角形缺陷团簇,造成高度差。
外延凸起对晶片的外延层平整度和后续器件制造过程有一定影响,因此在生长过程中需要采取措施减少这种缺陷的产生。
乳凸 (Bump)
乳凸 (Bump) 是4H-SiC(碳化硅)外延生长中的一种表面形貌缺陷,具有以下特点:
1.形貌特征:乳凸是指外形为凸点或凸起状的形貌缺陷,但在表面观察不到明显的异物。在光致发光(PL)光谱中也观察不到任何特定图案。

乳凸光学图像
2. 产生原因:乳凸的形成通常是由于小尺寸微小颗粒、3C碳化硅颗粒、碳包裹体等在外延生长前阶段掉落在晶片表面,随后在外延生长过程中形成凸起形状。乳凸缺陷对晶片的表面平整度和光学性质有一定影响,因此在外延生长和清洁过程中需要注意减少这种缺陷的产生。
层错 (Stacking Fault, SF)
层错 (Stacking Fault, SF) 是4H-SiC(碳化硅)外延生长中的一种结晶缺陷,根据形貌特征可以分为三类:
1. SF (Stacking Fault):层错的一条或两条边界在外延层表面形成可观察的形貌,在光致发光(PL)图像中呈三角形图案。这类层错在表面光学图像中可以直接观察到。
2. SSF (Single Stacking Fault):表面光学图像观察不到相应的形貌和特征,但在光致发光图像中呈现三角形图案。这类层错在表面光学图像中不易观察到。
3. BSF (Bar Stacking Fault):表面光学图像观察不到相应的形貌和特征,但在光致发光图像中呈现条状图案。这类层错通常是由衬底层错向外延层的贯穿形成的Frank型层错。

有两条不全位错边界形貌的外延层层错(SF 型)的表面光学(a)和 PL(b)图像
产生原因
- SF和SSF:这些是4H-SiC外延层的原生型层错,由于它们的形成能很小,任何微小扰动都有可能引起堆垛序列的错误从而导致它们的形成。这些扰动可能包括CVD生长室清洁度、衬底表面状态、外延工艺稳定性、衬底位错滑移等。
- BSF:这种层错是由衬底层错向外延层的贯穿形成的Frank型层错。
螺位错 (Threading Screw Dislocation, TSD)
螺位错 (Threading Screw Dislocation, TSD) 是4H-SiC(碳化硅)外延生长中的一种结晶缺陷,具有以下特点:
1.形貌特征:外延层的螺位错(TSD)在没有引起其他形貌缺陷的情况下,通常在表面光学图像和光致发光(PL)图像中观察不到其相应的形貌和特征。但在熔融KOH腐蚀后,可以得到较大尺寸(相对于TED,即Threading Edge Dislocation)的六角形蚀坑。TSD位错经常在外延层表面引起小坑缺陷,小部分TSD会引起胡萝卜缺陷、台阶聚集或三角形缺陷。

外延层 TSD 和 TED 经过 KOH 腐蚀后的 光学图像
2. 产生原因:外延层中的TSD主要来自于衬底TSD向外延层的贯穿,其密度与衬底TSD密度接近。
刃位错 (Threading Edge Dislocation, TED)
刃位错 (Threading Edge Dislocation, TED) 是4H-SiC(碳化硅)外延生长中的一种结晶缺陷,具有以下特点:
1. 形貌特征:外延层的刃位错(TED)通常在表面光学图像和光致发光(PL)图像中观察不到其相应的形貌和特征。但在熔融KOH腐蚀后,可以得到较小尺寸(相对于TSD,即Threading Screw Dislocation)的六角形蚀坑。
2. 产生原因:外延层TED位错的产生主要有两个原因:
- 衬底TED位错贯穿到外延层。
- 非平行于<11-20>方向的衬底BPD(Basal Plane Dislocation)位错在外延生长初期镜像力的作用下向TED位错转化。
基平面位错 (Basal Plane Dislocation, BPD)
基平面位错 (Basal Plane Dislocation, BPD) 是4H-SiC(碳化硅)外延生长中的一种结晶缺陷,具有以下特点:
1.形貌特征:外延层的BPD在表面光学图像中贯穿到形貌特征,在光致发光(PL)图像中呈现平行于<11-20>方向的线型图案。在熔融KOH腐蚀后,BPD位错会形成贝壳形状的蚀坑。

外延层 BPD 的 PL 图像
2. 分布特点:
- 由衬底贯穿的BPD位错一般是孤立出现,长度基本满足关系式L=d/sin(θ),其中d为4H-SiC外延层厚度,θ为衬底表面的偏转角度(θ=4º)。
- 由三角形缺陷和微管等大尺寸形貌缺陷引起的BPD位错,会以形貌缺陷为中心,沿着<1-100>方向呈对称分布和多对出现。
- 由晶片边缘应力引起的BPD位错,分布特点是沿着<1-100>分布、数量巨大和分布密集。
- 由热应力引起的BPD位错,一般是沿着<1-100>方向成对出现,两个BPD位错之间的地方经常会伴随半环列阵(HLA)的出现。
3. 产生原因:
- 平行于<11-20>方向的衬底BPD位错向外延层贯穿。
- 三角形缺陷和微管等大尺寸形貌缺陷造成周边晶格应变,需要通过形成BPD位错来使应力释放。
- 晶片边缘由于机械磨抛加工和外延生长过程中的边缘效应所产生的应力引起大量BPD位错的形成。
- 在晶格失配的前提下,较大的温度不均匀引起热应力与晶格失配应力方向一致时,作用力的叠加使已经存在的BPD位错产生滑移,增殖形成多个BPD位错。
半环列阵 (Half Loop Array, HLA)
半环列阵 (Half Loop Array, HLA) 是4H-SiC(碳化硅)外延生长中的一种特殊结晶缺陷,具有以下特点:
1.形貌特征:半环列阵(HLA)在光致发光(PL)图像中观察到的点状或短线沿<1-100>方向列阵组成的半环型缺陷,通常出现在两对BPD位错之间。通过熔融KOH腐蚀可以发现,HLA的本质就是BPD位错的滑移过程中沿途留下的BPD碎片列阵。

外延层 HLA 经过 KOH 腐蚀后的光学图像
2. 产生原因:微管、三角形缺陷和热应力引起的外延过程中BPD位错滑移,都有可能产生HLA。这些因素影响BPD位错的运动,导致BPD位错在滑移过程中留下碎片形成半环列阵。
图片来源:国标《碳化硅晶体材料缺陷图谱》
更多推荐
 已为社区贡献18条内容
已为社区贡献18条内容







所有评论(0)